量测和检测对于半导体制造过程的管理非常重要。半导体晶圆的整个制造过程有400到800个步骤,需要一到两个月的时间。如果在流程的早期出现任何缺陷,后续耗时工艺中所做的所有工作都将被浪费。因此,在半导体制造工艺的关键点建立量测与检测流程,可以有效确保和维持良率。
01
半导体中的量测
在半导体制造过程中,"量测"(Metrology)指的是使用各种技术和设备对晶圆(wafer)和芯片进行测量和监控,以确保制造工艺的精度和产品的质量。量测技术在半导体制造中的应用贯穿整个生产过程,从前道工序(如光刻、刻蚀、沉积等)到后道工序(如封装和测试),确保每一步工艺的精度和质量,最终提高产品的良率和性能。量测在半导体制造中扮演着关键角色,以下是一些常见的量测技术和它们的应用:
1. 光学显微镜和扫描电子显微镜(SEM)
2. 薄膜厚度测量
3. 关键尺寸(Critical Dimension, CD)量测
4. 光掩模(Photomask)和掩模检测
5. 电特性测量
6. X射线和光电子能谱(XPS)
7. 化学机械抛光(CMP)量测
8. 颗粒检测和表面缺陷检测
9. 翘曲度测量
02
量测案例
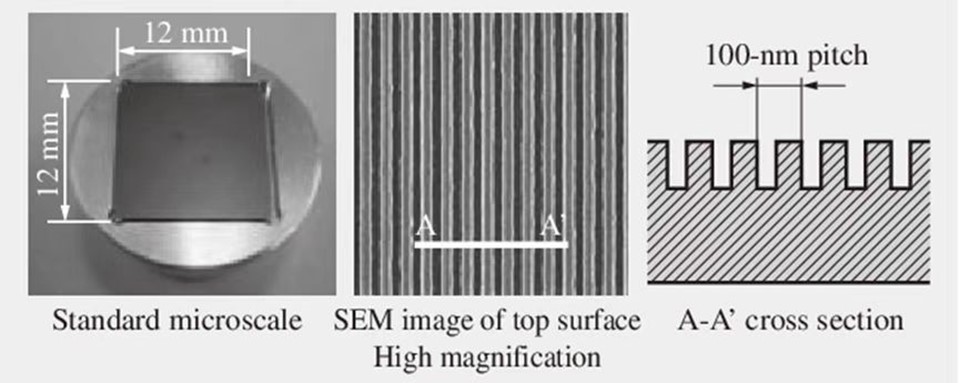
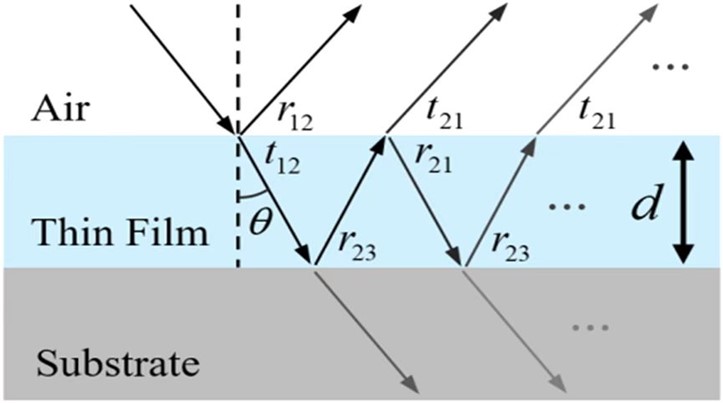

量测通常是指使用量测设备来测量关键结构参数与体积的方法。
量测虽然通常被认为是测量的同义词,但它是一个更全面的概念,它不仅指测量行为本身,还指通过考虑误差和精度以及量测设备的性能和机制来执行的测量。如果图案测量结果不在给定的规格范围内,则制造的器件不能按设计运行,在这种情况下,电路图案的曝光转移可能需要返工。测量点的数量因半导体器件制造商或器件而异。新设计的器件在制造的启动阶段可能会经历数千个晶圆的量测过程。
03
半导体中的检测
涉及使用检测设备根据特定标准检测是否符合要求,以及异常或不适合的情况,是一个检测晶圆中任何颗粒或缺陷的过程。具体来说,其目的是找到缺陷的位置坐标(X,Y)。
缺陷的原因之一是灰尘或颗粒的粘附。因此不可能预测哪里会出现缺陷。如果晶圆表面出现大量缺陷,则无法正确创建电路图案,从而导致图案缺失,阻止电子电路正常运行,从而使晶圆成为有缺陷的产品。检测缺陷并指定其位置(位置协调)是检测设备的主要作用。
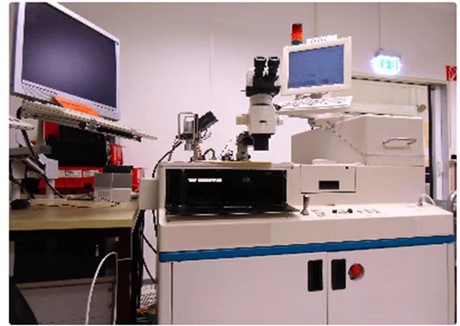
主要的半导体制造工艺包括相当于印刷版的光掩模制造工艺、作为半导体基础的晶圆制造工艺、利用光掩模在晶圆上形成精细电路结构的前端工艺以及后端工艺。电路形成后封装单个半导体芯片的最终过程。如果我们看细节的话,有上百个流程。
检测设备在生产率如此高的半导体制造过程中极其重要,可以尽早剔除缺陷产品,降低成本,提高质量和可靠性。选择半导体检测设备的标准应考虑晶圆的直径、要使用的工艺以及要检测的缺陷类型。
半导体检测设备用于半导体制造过程的各个阶段。检测缺陷包括光掩模和晶圆上的变形、裂纹、划痕和异物,前道工序中形成的电路图案的错位,尺寸缺陷,后道工序中的封装缺陷等。半导体制造的难点在于需要上百甚至上千个步骤的紧密配合,每一步都要严格按照设计目标进行,才能最终制作出所需的器件。各个工艺步骤之间的协调和前后对准是基本要求。因此,缺陷检测和过程监控至关重要。
缺陷检测(Defect Inspection)
指在半导体制造过程中,使用各种技术和设备对晶圆和芯片进行检查,以识别和定位潜在的缺陷。这些缺陷可能包括颗粒污染、划痕、蚀刻残留、膜层不均匀等。主要包括无图形缺陷检测(Non-patterned Defect Inspection)和有图形缺陷检测(Patterned Defect Inspection) 。
3.1 无图形缺陷检测
在半导体制造过程中,无图形缺陷检测专注于在晶圆和芯片的无图形区域内发现和识别缺陷。与图形化区域不同,无图形区域通常是平滑的,没有复杂的结构和特征,因此更容易识别微小的缺陷。无图形缺陷包括颗粒污染、表面粗糙度异常、薄膜厚度不均匀、微裂纹等。

3.1.1 主要检测方法
a.光学检测(Optical Inspection)
b.激光散射检测(Laser Scattering Inspection)
c.扫描电子显微镜(SEM)
d.原子力显微镜(AFM)
e.光学轮廓仪 (Optical Profilometer)
f.化学机械抛光(CMP)检测
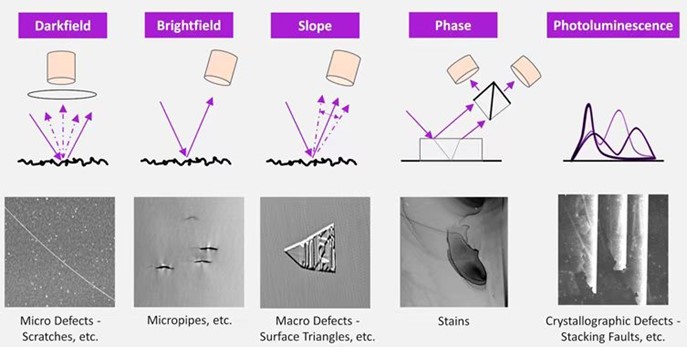
3.1.2 应用场景

3.1.3 总结
无图形缺陷检测对于确保半导体器件的整体质量和可靠性至关重要。尽管这些区域没有复杂的图形,但任何微小缺陷都可能在后续工艺中被放大,影响器件的性能和可靠性。因此,及时检测和修复无图形区域的缺陷是保证高质量半导体产品的关键。
3.2 有图形缺陷检测
有图形缺陷检测是半导体制造过程中至关重要的一部分,主要关注在已经刻蚀或形成图形的区域内检测缺陷。这些缺陷可能包括图形偏差、蚀刻缺陷、残留物、颗粒污染等,直接影响到器件的功能和性能。
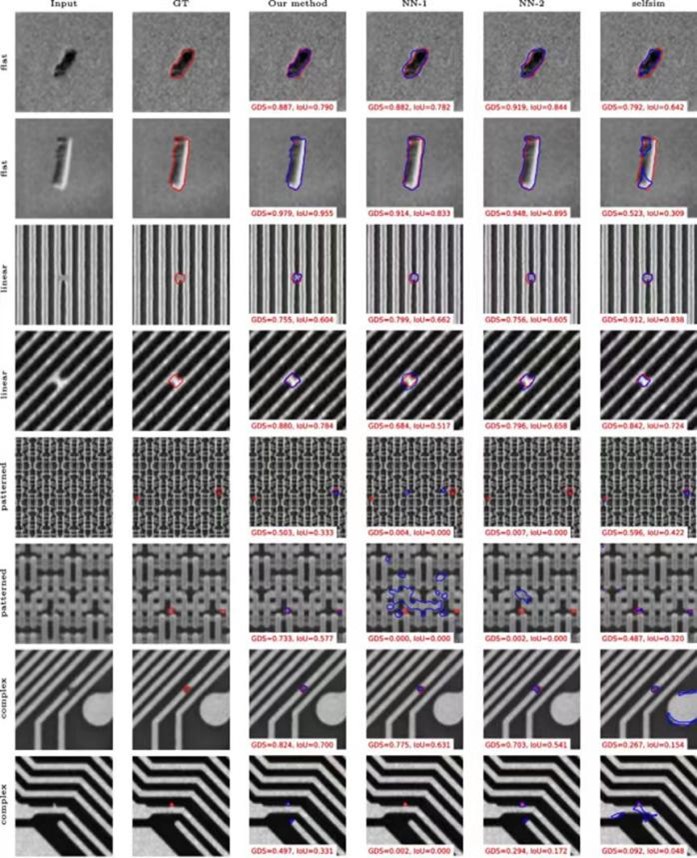
3.2.1 主要检测方法
a.自动光学检测(Automated Optical Inspection, AOI)
b.扫描电子显微镜(SEM)
c.电子束检测(E-beam Inspection)
d.光学干涉检测(Optical Interference Inspection)
e.缺陷分类和分析软件
f. 化学机械抛光(CMP)后的图形缺陷检测

3.2.2 应用场景
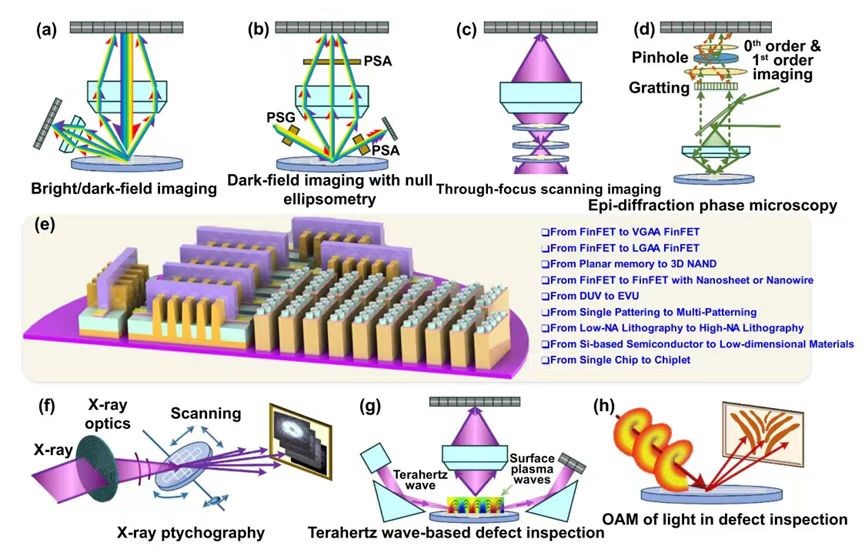
3.2.3 总结
有图形缺陷检测对于保证半导体器件的性能和可靠性至关重要。任何微小的图形缺陷都可能导致器件失效或性能下降,因此需要高精度的检测技术和设备来及时发现和修复这些缺陷。这不仅提高了生产良率,还确保了最终产品的质量和可靠性。
3.3 掩模版缺陷检测(Reticle Inspection)
掩模版缺陷检测是在半导体光刻过程中,对光掩模(也称为掩膜版或光罩)进行检查以发现并修复缺陷的过程。光掩模是光刻工艺中将电路图形转移到晶圆上的关键组件,其质量直接影响到晶圆上图形的精确度和最终器件的性能。这些缺陷可能包括颗粒污染、图形断裂、桥接缺陷和光掩模材料的缺陷。

3.3.1 主要检测方法
a.光学显微镜(Optical Microscopy)
b.自动光学检测(Automated Optical Inspection,AOI)
c.扫描电子显微镜(SEM)
d.电子束检测(E-beam Inspection)
e.激光散射检测(Laser Scattering Inspection)
f.光学干涉检测(Optical Interference Inspection)
g.缺陷修复
3.3.2 应用场景

3.3.3 总结
掩模版缺陷检测对于半导体制造的成功至关重要。掩模版上的任何缺陷都会在光刻过程中被放大并转移到晶圆上,导致器件性能下降甚至失效。因此,通过高精度的缺陷检测和及时的修复,保证掩模版的质量,对于提高生产良率和确保最终产品的可靠性至关重要。
04
其他
4.1 半导体 - 准确度与精密度
什么是高性能半导体计量设备?
传统的“性能”可以分为两种:“准确度与精密度”,或“真实度与重复性”。
“准确度”是衡量其接近“真实值”的程度。另一方面,“精密度”是衡量多次测量值变化的指标,也称为“重复性”。
请参考下图。

Fig.4.1.1 An example of shifts in measurement values
图 4.1.1显示了按时间序列绘制的半导体器件测量结果。
如果使用计量系统重复测量同一半导体对象,则测量结果应该始终相同。但实际上,测量值会根据干扰和噪声而变化。
测量值的频率分布如图 4.1.2 所示。
当收集大量测量数据时,数据分布将近似于高斯(正态)分布,如图 4.1.2 所示。分布的特征用平均值:μ(mu)和标准偏差:σ(sigma)表示。数据落入 μ±3σ 内的概率为 99.73%。
μ:平均值
σ:标准偏差

Fig.4.1.2 Gaussian (normal) distribution
图 4.1.3(a)中σ较小,表示变异较小;图4-3(b)中σ较大,表示变异较大。变异较小时,精度(或重复性)较高(良好)。

Fig.4.1.3 Gaussian(normal) distribution (Part 2)
这可以比作用枪射击目标。
当变化小时,弹孔将停留在一小块区域内(图 4.1.4(a)右图)。
当变化大时,弹孔将扩散到大面积区域(图 4.1.4(b)右图)。
高重复性并不能保证真实值(正确值或目标中心)。图 4.1.4 是远离真实值(目标中心)的测量值的示例。
当平均值(μ)接近真实值时,真实性或准确度就很高。
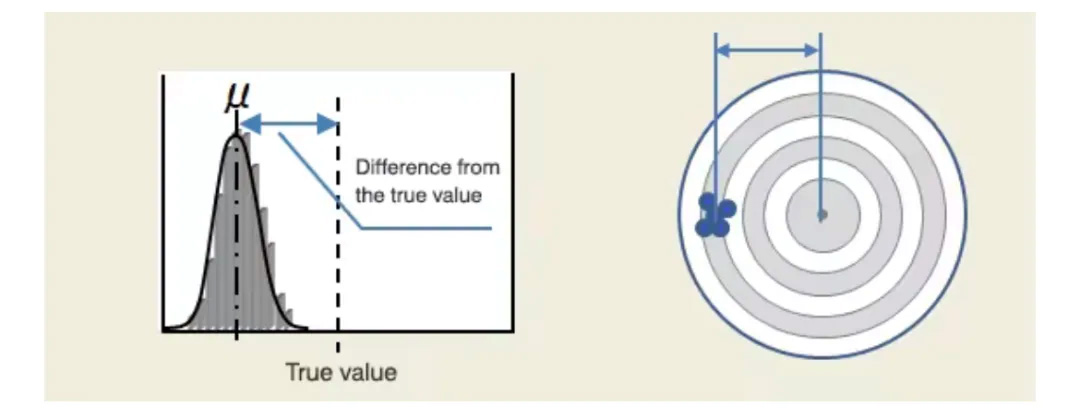
Fig.4.1.4 Gaussian (normal) distribution (Part 2)
以下是简要总结:
变化(σ)小意味着精度高(好)。
平均值(μ)接近真实值意味着准确度高(好)。
如图 4.1.5 所示。

Fig.4.1.5 Precision and accuracy
像临界尺寸 SEM (CD-SEM) 这样的测量系统需要高精度。
高精度系统意味着高性能测量系统。CD-SEM 的测量重复性约为 3σ 内测量尺寸的 1%。
可以使用标准微量尺等测量标准进行校准,调整精度,使测量值与真实值一致。
4.2 CD-SEM - 什么是临界尺寸SEM?
临界尺寸SEM(CD-SEM:临界尺寸扫描电子显微镜)是一种专用系统,用于测量半导体晶圆上形成的精细图案的尺寸。CD-SEM主要用于半导体电子设备的生产线。
CD-SEM与通用SEM的三个主要区别在于:
1)照射到样品上的CD-SEM一次电子束的能量低至1keV或以下。
2)降低CD-SEM电子束的能量可以减少由于充电或电子束照射对样品造成的损坏。
3)通过最大限度地提高放大倍率校准,可以保证CD-SEM测量的准确性和重复性。
CD-SEM的测量重复性约为测量宽度的1% 3σ。
晶圆上的精细图案测量是自动化的。样品晶圆放在晶圆盒(或Pod / FOUP)内,晶圆盒放在CD-SEM上。尺寸量测的条件与步骤,会预先输入至配方*中,当量测开始时,CD-SEM 会自动将样品晶圆从卡匣中取出,并放入 CD-SEM 中,量测样品上所需的位置,量测完成后,晶圆会放回卡匣中。
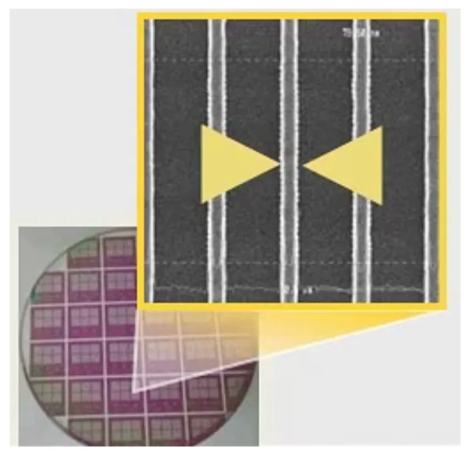
Fig.4.2.1 Measuring a fine pattern on a wafer.
* Recipe: A recipe is a program (a collection of procedures, processing methods, parameters and input data) input into manufacturingsystem such as CD-SEM.
测量原理
CD-SEM 使用 SEM 图像的灰度(对比度)信号。
首先,光标(位置指示器)在 SEM 图像上指定测量位置。
然后获取指定测量位置的线轮廓。线轮廓基本上是指示测量特征的地形轮廓变化的信号。
线轮廓用于获取指定位置的尺寸。CD-SEM 通过计算测量区域中的像素数来自动计算尺寸。
CD-SEM 图像
下面显示了 CD-SEM 获得的 SEM 图像示例。图 4.2.2 显示了在光刻胶线的 SEM 图像上方绘制的线轮廓。光刻胶线的横截面图与 SEM 图像之间的关系如图 4.2.3 所示。
此外,线横截面与其线轮廓之间的关系如图 4.2.4 所示。
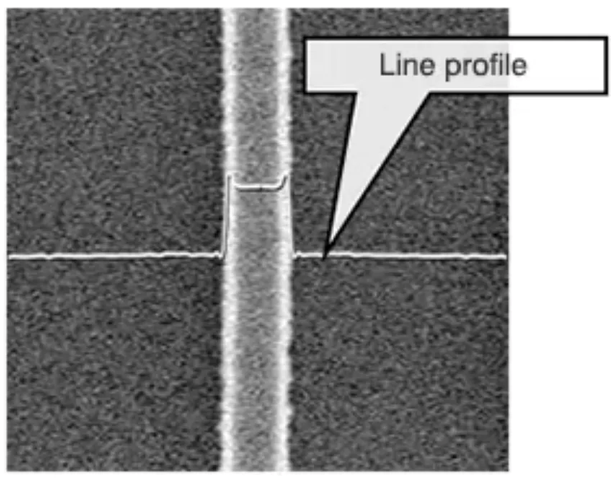
Fig.4.2.2 Photoresist line (SEM image) and line profile
也就是说,图 4.2.2 中的图像给出了线轮廓,而轮廓又给出了线宽。如果线横截面呈梯形,如图 4.2.4 所示,则顶部和底部的宽度将不同。在这种情况下,测量位置将在配方中指定。此外,还可以指定所需的高度位置。
SEM image
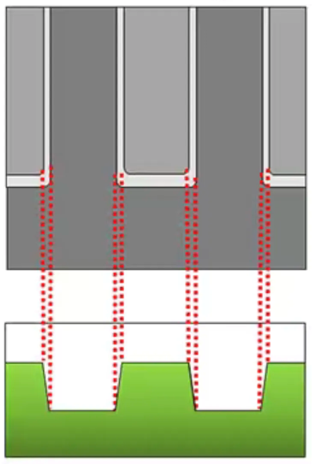
A schematic cross-sectional view
Fig.4.2.3Relationship between the SEM image ofline & space and the schematic cross-sectionalview
Line profile
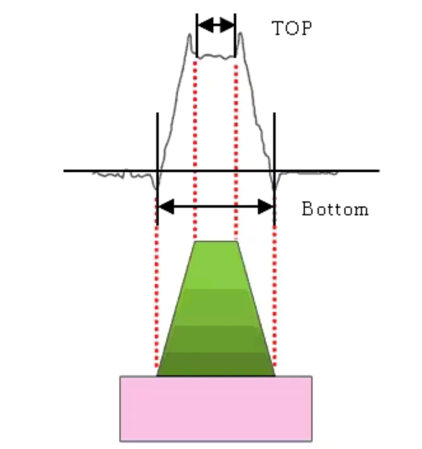
A schematic cross-sectional view
Fig.4.2.4 Relationship between the line schematiccross-sectional view and the line profile
测量过程
临界尺寸测量主要在晶圆制造工艺的以下操作中进行。
显影后光刻胶图案的临界尺寸测量
蚀刻后接触孔直径/通孔直径和布线宽度的测量
4.3 晶圆缺陷检测系统
晶圆缺陷检测系统检测晶圆上的物理缺陷(称为粒子的异物)和图案缺陷,并获取缺陷的位置坐标(X,Y)。缺陷可分为随机缺陷和系统缺陷。
随机缺陷主要由附着在晶圆表面的粒子引起,因此无法预测其位置。晶圆缺陷检测系统的主要作用是检测晶圆上的缺陷并找出其位置(位置坐标)。
另一方面,系统缺陷是由掩模和曝光工艺的条件引起的,并且会出现在所有投影的芯片的电路图案上的相同位置。它们出现在曝光条件非常困难且需要微调的位置。
晶圆缺陷检测系统通过比较相邻芯片的电路图案的图像来检测缺陷。因此,有时无法使用传统的晶圆缺陷检测系统检测到系统缺陷。
可以在图案化工艺晶圆或裸晶圆上进行检查。它们中的每一个都有不同的系统配置。以下是典型检查系统的说明;图案化晶圆检测系统和非图案化晶圆检测系统。

缺陷检测原理
图案化晶圆检测系统
图案化晶圆检测系统有很多种,包括电子束检测系统、明场检测系统和暗场检测系统。每种系统都有自己的特点,但基本的检测原理是相同的。
在半导体晶圆上,相同图案的电子器件并排制作。顾名思义,随机缺陷通常是由灰尘等颗粒引起的,并且发生在随机位置。它们在特定位置重复出现的可能性极低。
因此,图案化晶圆检测系统可以通过比较相邻芯片(也称为裸片)的图案图像并获得差异来检测缺陷。
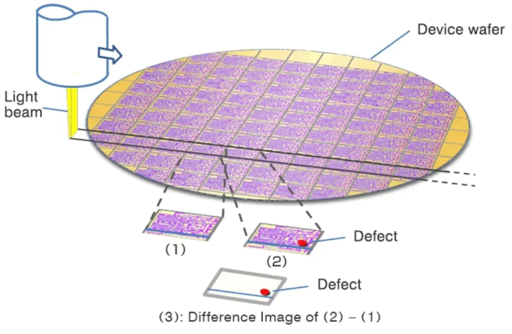
Fig.4.3.1.Principles of defect detection on a patterned wafer
图 4.3.1 显示了检测图案化晶圆上的缺陷的原理。
晶圆上的图案通过电子束或光线沿芯片阵列捕获。通过比较待检测芯片的图像(1) 和相邻芯片的图像 (2) 来检测缺陷。如果没有缺陷,则通过数字处理将图像 2 从图像 1 中减去的结果将为零,并且不会检测到任何缺陷。相反,如果芯片 (2) 的图像中有缺陷,则缺陷将保留在减去后的图像 (3) 中,如图所示。然后检测缺陷并记录其位置坐标。
非图案化晶圆检测系统
非图案化晶圆检测系统用于晶圆制造商的晶圆出货检测、设备制造商的晶圆入货检测以及使用虚拟裸晶圆进行的设备状态检查,以监控设备的清洁度。设备制造商在出货检测时也会进行设备状态检查,设备制造商在设备入货检测时也会进行设备状态检查。
为了检查设备的清洁度,将用于清洁度监测的裸晶圆装入设备中,然后移动设备内部的平台来监测颗粒的增加情况。
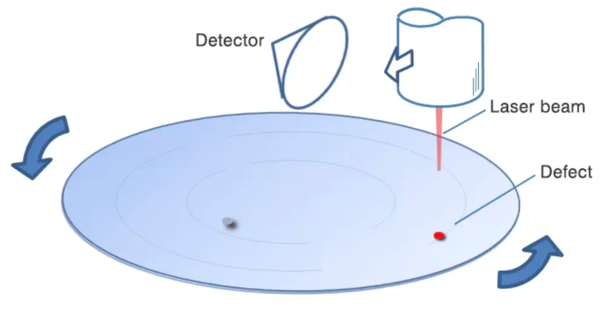
Fig.4.3.2.Principle of defect detection on a non-patterned wafer(1)
图 4.3.2 显示了检测无图案晶圆上的缺陷的原理。
由于没有图案,因此无需图像比较即可直接检测缺陷。
将激光束投射到旋转的晶圆上,并沿径向移动,以便激光束能够照射晶圆的整个表面。
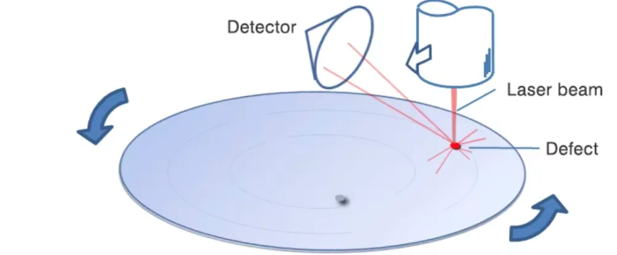
Fig.4.3.3 Principle of defect detection on a non-patterned wafer(2)
当激光束投射到旋转晶圆的颗粒/缺陷上时,光会发生散射并被检测器检测到。因此,检测到颗粒/缺陷。根据晶圆旋转角度和激光束的半径位置,计算并记录颗粒/缺陷的位置坐标。镜面晶圆上的缺陷除了颗粒外,还包括COP等晶体缺陷。
一般来说,明场检测系统用于详细检查图案缺陷。另一方面,暗场检测系统可以高速检测,用于大量晶圆的缺陷检测。
在电子束检测系统中,电子束照射到晶圆表面,检测发射的二次电子和背向散射电子。
此外,电子束检测系统根据设备内部布线的导电性,将二次电子的数量检测为图像对比度(电压对比度)。如果检测高深宽比的接触孔底部的电导率,可以检测到超薄厚度的SiO2残留物。

Fig.4.3.4. An example of detecting the residue at thebottom of a contact hole.
Introducing the product lineup of Defect Review SEM& Defect Inspection Systems
4.4 ReviewSEM - 什么是review SEM?
缺陷review SEM是一种扫描电子显微镜 (SEM),用于审查晶圆上发现的缺陷。半导体晶圆缺陷检测系统检测到的缺陷使用审查 SEM 放大为高倍图像,以便对其进行审查和分类。缺陷审查 SEM 主要与电子设备和其他半导体生产线中的检测系统一起使用。
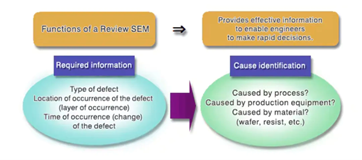
Review SEM 的作用
Review SEM 的工作方式一般如下:
事先使用检查系统检测晶圆缺陷。
检查系统列出缺陷的位置坐标并将其输出到文件中。
将检查的晶圆和检查结果文件加载到 Review SEM 中。
拍摄列表中缺陷的图像。
根据缺陷列表中的位置信息确定缺陷位置。然后由 Review SEM 拍摄并存储缺陷图像。
使用检查系统检测几千到几万个缺陷,并将数据输出到文件中。可以在 Review SEM 的配方操作设置中指定是否检查并拍摄所有或部分缺陷的照片。
有时无法使用缺陷数据文件中的位置信息找到晶圆上的缺陷。由于各种错误,仅使用位置信息很难找到缺陷。
在缺陷检查系统中,将缺陷图像与相邻的芯片图像(参照图像)进行比较,并根据图像差异(差异图像处理)检测缺陷。
Review SEM 与缺陷检测系统类似,通过与相邻芯片的电路图案进行比较来检测缺陷,并获得缺陷的正确位置。然后将缺陷移到视野中心并拍摄放大的照片。
在 Memory IC 的缺陷检查中,其中单元图案重复排列,单元的最小单位图像预先注册为参考图像。在 Review SEM 上检测缺陷的一种方法是使用差异图像处理将缺陷图像与参考图像进行比较。这种方法可以加快 Review SEM 上的缺陷检测速度,因为可以将多个部分与同一参考图像进行比较。

ADR功能
ADR代表自动缺陷检查。缺陷检查的目的是更详细地观察、分类和分析晶圆检测系统检测到的缺陷和颗粒的形状和成分。
自动缺陷检查使用缺陷检查中获得的缺陷信息(坐标等)自动获取所需缺陷的图像。数据存储并整理到数据库中。
在缺陷检查SEM中,使用ADR功能自动获取并存储缺陷图像。
ADC功能
ADC代表自动缺陷分类。存储在图像服务器中的缺陷图像信息由分类软件根据预定规则根据缺陷原因进行分类,然后在分类服务器中恢复。分类信息被发送到产量管理系统(YMS)和IC制造商的主机,以便可用于故障和缺陷分析。
一些系统可以结合缺陷检查SEM的ADR功能使用ADC对缺陷进行分类。ADR获得的缺陷信息也可以在后期进行集体分类。
本文转载自:芯系半导体、Semi Dance
转载内容仅代表作者观点
不代表上海隐冠半导体立场