1、混合键合是高集成堆叠最终方案
混合键合是实现高密度堆叠的核心路径。随着高性能运算带动的多颗芯片垂直互联要求提升,传统的微凸点技术面临焊料电迁移、热迁移、桥连短路等可靠性加剧的问题,不再满足堆叠尺寸极小、I/O密度要求极高的堆叠需求,混合键合(或称Cu-Cu直接键合)工艺应运而生。倒装键合工艺pitch尺寸在50~100μm、热压键合工艺可将pitch size缩小到20μm,而要进一步缩小尺寸,则必须求助于混合键合工艺。混合键合的本质是,将铜/SiO2打磨出极其光滑的表面,稍微施加压力或高温,在范德华力的作用下,就可以实现永久键合。由于Cu-Cu、SiO2-SiO2、Cu-SiO2界面间都可以同时键合,因此称为混合键合。该技术的关键点在低粗糙度的磨平方法、高精度的对准方法、晶圆翘曲的控制方法和铜焊盘凹陷的控制方法等。为了增强表面结合力,需要增加等离子活化等工序,再通过高精度倒装热压,实现多界面间的混合键合。混合键合的核心要素有三:高洁净度(nm级控制)、高平整度及粘合强度,因此需要先进的前端设备及更贵的洁净室。可以看出,混合键合更类似于前道工艺,而非后道封装工艺。

(混合键合能实现最高密度堆叠)
2、W2W趋近成熟,D2W正崛起
混合键合工艺混合键合可分为Wafer to Wafer 及Die to Wafer两类。前者主要应用于3D NAND、CIS等Wafer间堆叠,对准精度要求极高,偏移量在小百nm以内,目前已实现量产。典型代表如长存3D NAND X-stacking架构,先在CMOS外围电路和NAND存储阵列两片晶圆上完成独立的制造工艺,再通过混合键合的方式进行两片晶圆的链接。目前 EVG约占据W2W混合键合82%市场,其次为TEL公司。EVG单台设备价值量约为 500~800万欧元/台。
Die to Wafer则主要应用于芯片异构集成,例如SoIC、未来HBM4堆叠等,对准精度要求一致,但对机台速率及清洁度提出更高要求。当前,D2W尚未十分成熟,BEIS凭借其机台优异良率,基本成为该领域核心玩家。台积电SoIC平台即基于此工艺,AMD 2023年发布的AI芯片MI300系列产品即搭配SoIC和CoWoS封装,实现12颗晶粒的chiplet堆叠。苹果M5系列芯片也计划采用台积电SolC封装技术。为满足客户需求,台积电持续扩产,2023年底SoIC月产能2000片,目标2024年底6000片/月,2025年有望提升至 1.4~1.45万片/月。当前,Besi设备可以实现10μm以下的连接点间距0.5-0.1μm的对准精度,以及1w~100w连接点/mm2的连接密度。单台设备价值量也迅速提升,以Besi为例,同系列倒装用固晶机单价大约50万美元/台,而混合键合设备单价将提升至150~250万美元。
3、受AI算力拉动,混合键合空间广阔
当前,混合键合设备尚处于产品导入期,在图像传感器、逻辑芯片和存储器领域初步实现产业化。三星将在XCube、Saint平台上均将采用混合键合,分别用于内存-内存、逻辑芯片-存储芯片/逻辑芯片的堆叠,英特尔则将把其应用在Foveros上,有望在2024年率先实现逻辑芯片与互连器之间的混合键合技术。此外,海力士也可能率先使用混合键合至其 HBM4芯片上。混合键合核心应用主要为:逻辑端,SoIC 3D chiplet堆叠、SRAM+Logic堆叠及GAA背面供电;存储端,3D NAND(W2W)、HBM(>16层,D2W)、3D DRAM等;及背照式CMOS图像传感器。根据Yole预测,当前虽然还没有HBM应用混合键合,随着堆叠层数增加、集成度要求更高,2028年混合键合工艺预计将占据HBM所用工艺的36%。根据Besi预测中性假设下,2030年对混合键合系统需求将达到1400台,以200万欧元测算,设备市场累计总空间为28亿欧元。根据Yole测算,2027年W2W和D2W混合键合设备市场空间预计达到5亿/2.3亿美元。混合键合已成为全球半导体设备厂重点布局方向,包括AMAT、ASMPT、Shibaura、TEL、SUSS等纷纷入局,国内大陆公司包括拓荆科技、华卓精科等。
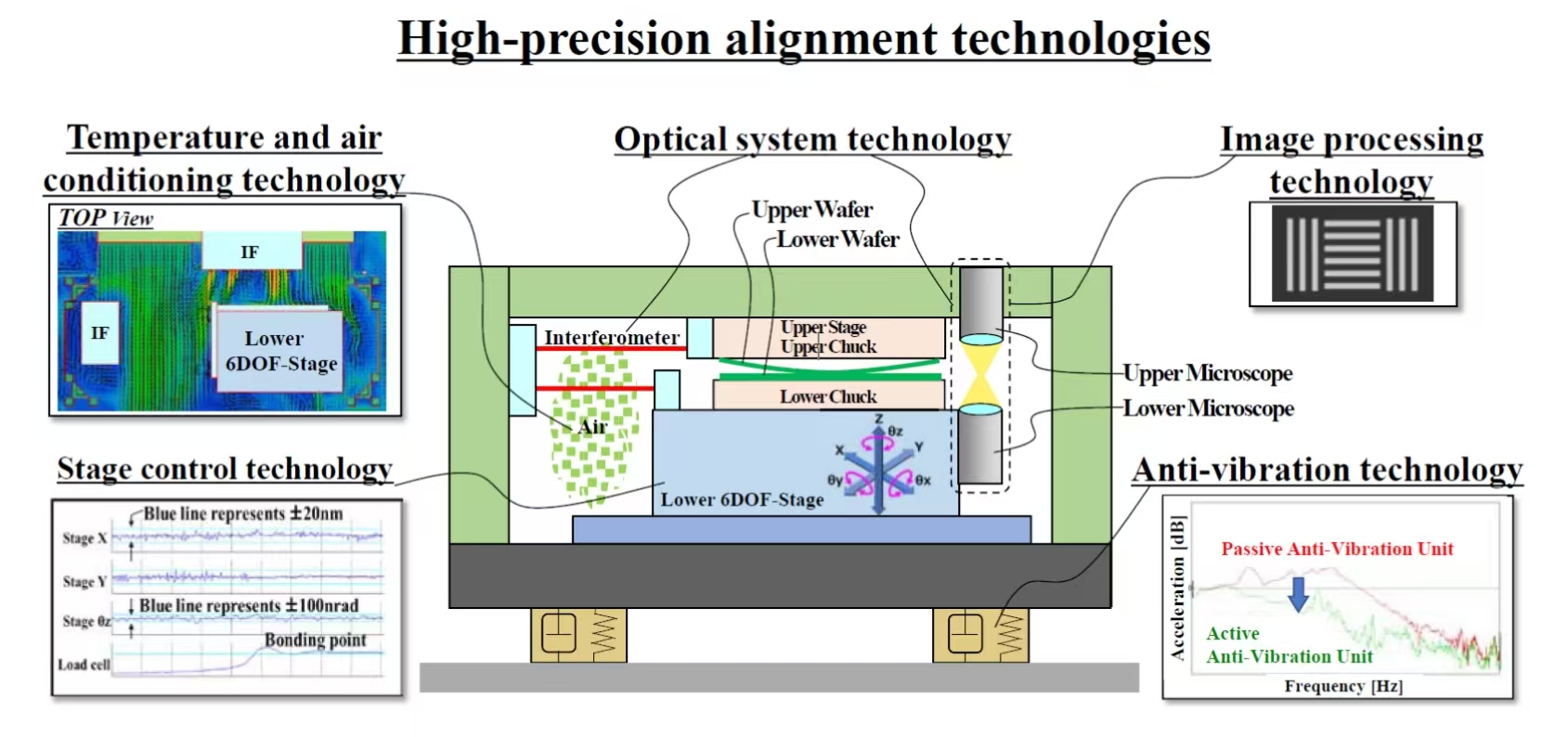
(混合键合设备示意图,图片来源自网络)
4、隐冠解决方案及特点
针对半导体混合键合设备这个领域,隐冠基于多年的精密运动系统开发经验,可提供高速、高精度的粗微动架构运动系统。对于晶圆快速到位,可提供高速、高精度的气浮运动平台,对于超精密晶圆对位,可提供nm级定位精度的压电定位平台。对于Z轴,可定制磁浮式音圈电机、主动式水冷音圈电机、磁力弹簧等核心零部件解决方案,有效提高Z轴的精度,降低Z轴发热风险。通过隐冠高度模块化的设计,更加便于客户以低拥有成本来实现极大的配置灵活性。
隐冠半导体拥有覆盖全国主要城市的售后团队,为您提供全方位的技术支持。
(最新行业技术数据来自于网站等其他公开信息来源)