1、先进封装延续摩尔定律,市场规模持续增长
先进封装是对应于先进圆晶制程而衍生出来的概念,一般指将不同系统集成到同一封装内以实现更高效系统效率的封装技术。换言之,只要该封装技术能够实现芯片整体性能(包括传输速度、运算速度等)的提升,就可以视为是先进封装。与之对应的传统封装则是将各个芯片单独封装好,再将这些单独的封装芯片装配到PCB主板上构成完整的系统,通过PCB板形成电信号之间的互连。在工业界,一般将芯片的正装封装划分为传统封装,芯片与芯片(芯片与PCB板)之间通过键合金丝进行连接。而先进封装一般指倒装的封装形式,芯片与芯片(芯片与PCB板)之间通过焊球进行互连。通常来说,芯片间的信息传输距离越长,信息传递越慢,芯片组系统的性能就越低。因此,同一芯片水平下,先进封装的传输距离更短,对应系统的性能越强。
先进封装可以粗略地分为两大类,即倒装(Flip Chip)和晶圆级封装(Wafer Level Package,简称WLP)。近年来,基于这两大类封装形式,又衍生出多种具体的封装工艺,包括FCBGA、FCLGA、2.5D/3D封装、Fanout、FCCSP等。尽管很多先进封装技术只有微小的区别,但是由于不同应用领域的客户的产品定制化的需求,行业中出现大量的不同种类的先进封装。
从下游应用来看,诸如服务器、AI芯片、PC、交换机、大功率的矿机等需要高传输速率的应用场景大多采用Flip Chip形式的封装工艺,而智能手机、WiFi、射频芯片、电源管理芯片、小功率的矿机则通常采用WLP形式的封装工艺。对于闪存、分立器件等低传输、低算力应用场景仅需要用到打线(Wire Bond)形式、引脚(QFN/QFP/SOP)形式或者引线框架形式的传统封装。
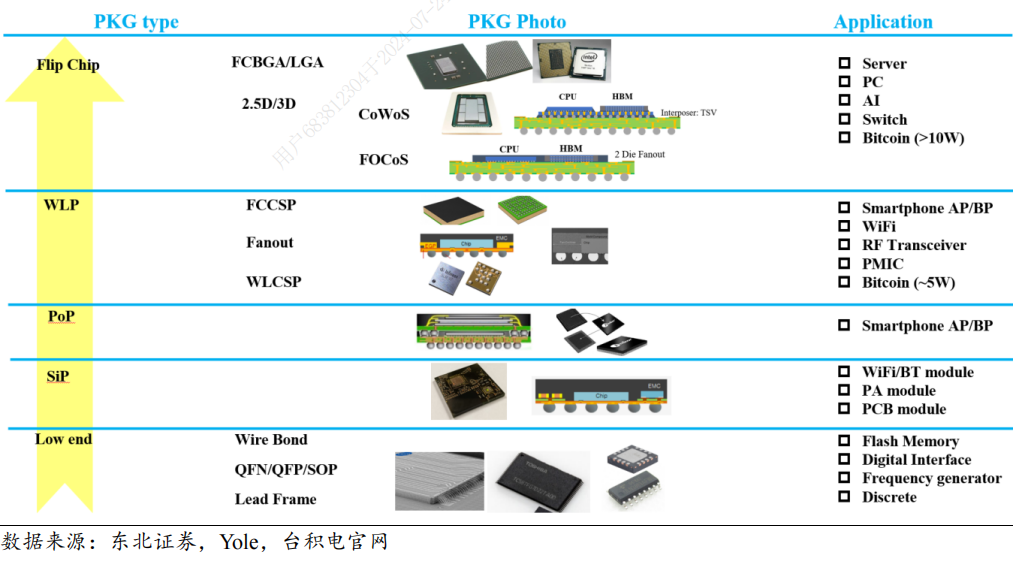
(封装类型全景)

(先进封装类型图)
传统封装市场规模更大,但先进封装增速显著。据Yole数据,2022年全球先进封装市场规模为443亿美元,预计2022-2028年的复合增长率将达到10.03%,2028年全球先进封装市场规模将达到786亿美元。而传统封装的增长速度较慢,2022年全球市场规模为507亿美元,2022-2028年复合增长率仅为4.15%,预计2028年传统封装市场规模将达到647亿美元,全球总封装市场规模达到1433亿美元。从份额来看,2022年全球先进封装市场份额为46.6%,预计将在2025年超过传统封装达到51%,在2028年份额进一步提升至54.8%。
从半导体制程进入10nm 以来,摩尔定律已经失效,即芯片迭代不再满足“集成电路芯片上所集成的晶体管数目,每隔18个月就翻一番;微处理器的性能每隔 18个月提高一倍,而价格下降一倍”。在后摩尔定律时代,对于“more than moore”的延续,先进封装是业界公认的有效途径。
2、先进封装市场规模扩张带动先进固晶机需求增长
芯片键合机(Die Bonder),又称固晶机,是半导体后道封测的芯片贴装(Die attach)环节中最关键、最核心的设备。键合机主要用于裸芯片或微型电子组件的贴装将芯片安装到引线框架(Lead frame)、热沉(Heat sink)、基板(Substrate)或直接安装到PCB板上,以此来实现芯片与外部之间的电连接。通常来说,芯片键合不仅要求封装好的芯片产品能够承受后续组装的物理压力,并消散芯片工作期间产生的热量,还要求其必须保持恒定的导电性以及实现高水平的绝缘性。因此,随着芯片尺寸变得越来越小,性能要求不断提高,键合技术变得越来越重要,键合设备也成为了半导体后道封装设备中的关键一环,也承载了键合技术的进步。
键合工艺大体可分为传统键合和先进键合两种类型,传统方法需要芯片键合机(或称固晶机)和引线键合机的同时参与。传统方法包括芯片贴装(Die Attach)和引线键合(Wire Bonding)两个环节。在芯片贴装过程中,首先需在封装基板上点上粘合剂,随后将芯片顶面朝上放置固定在基板上。然后通过引线键合机将芯片正面的pad点连接到框架或基板焊盘上,目前工艺比较成熟。由于整个键合过程分为两步,因此需要芯片键合机(或称固晶机)和引线键合机两类设备参与。
在先进封装的产业趋势下,VLSI 预计固晶机2024年全球市场规模有望达15亿美元,LED 为重要的下游应用。且(先进)固晶机有望成为未来五年中市场规模增速最快的封装设备。
封测市场规模扩张带动固晶机需求增长,据华经产业研究院数据,预计2024年我国半导体固晶机市场规模达到51亿元,2029年将达81亿元,2024-2029年GAGR约为9.7%。固晶机设备为海外主导,国产替代空间广阔。
3、封装形式演变,固晶密度和精度要求提升
封装技术经历了从最初通过引线框架到倒装(FC)、热压粘合(TCP)、扇出封装(Fan-out)、混合封装(Hybrid Bonding)的演变,技术发展方向就是更多的 I/O、更薄的厚度,以承载更多复杂的芯片功能和适应更轻薄的移动设备。在此过程中,固晶的密度从 5-10/mm2提升到 10k+/mm2,精度从20-10um提升至0.5-0.1um,与此同时,能量/Bit则进一步缩小至0.05pJ/Bit,对固晶机的控制精度和工作效率都提出了更高的要求。
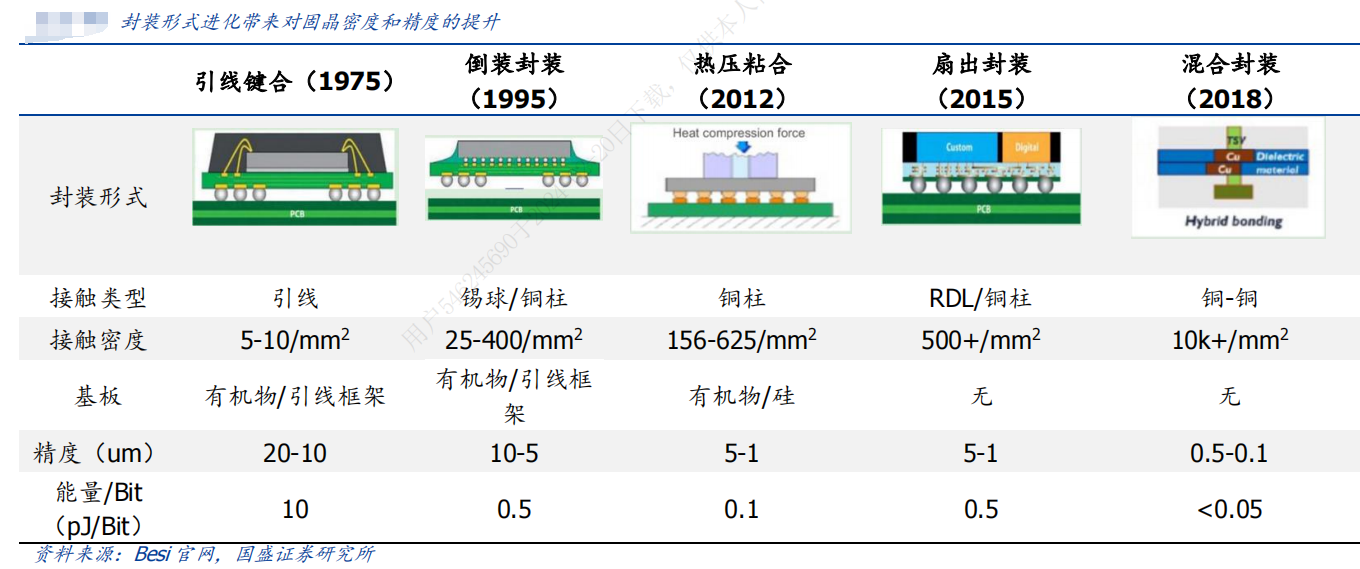
混合键合主要有两种应用方式,W2W应用较为成熟,D2W前景更广。第一种混合键合方式是晶圆到晶圆(W2W,Wafer to Wafer),主要用于CIS和NAND产品。作为异构集成的核心工艺,W2W混合键合已经在CMOS图像传感器和各种存储器、逻辑技术方面获得良好的成功记录。铜-铜混合键合最早出现在2016年,当时索尼将这项技术用于CMOS图像传感器,在堆叠的CMOS图像传感器的下部电路芯片和上部像素芯片之间利用铜混合键合。
4、隐冠解决方案及特点
针对半导体固晶机这个领域,隐冠基于多年的精密运动系统开发经验,可提供高速、高加速直驱运动台。针对高加速带来的冲击,可提供创新性的平衡质量减振技术。对于Z轴,可定制磁浮式音圈电机、主动式水冷音圈电机、磁力弹簧等核心零部件解决方案,有效提高Z轴的精度,降低Z轴发热风险。
隐冠半导体拥有覆盖全国主要城市的售后团队,为您提供全方位的技术支持。
(最新行业技术数据来自于网站)